ニュース
2025年12月11日
ノリタケ株式会社
AI時代を支えるTGV用銀ペーストの開発
~先端半導体の3D実装に向けたガラス基板を実用化へ~
ノリタケ株式会社 (本社:愛知県名古屋市、代表取締役社長:東山 明、以下 ノリタケ) は、3D実装された半導体パッケージ内の基板に貫通する配線を形成するThrough Glass Via※1 (以下 TGV) 用銀ペーストを開発しました。この技術により、膨大な演算処理が可能となり、AI技術の普及・拡大に貢献します。本開発品を、12月17日から開催される「SEMICON JAPAN 2025」に出展します。
市場環境
AIサーバーでは、膨大な演算処理により大量の電力を消費します。AIのさらなる普及・拡大に伴い、高速処理と低消費電力の両立が求められていますが、この課題を解決するため、薄型化し3Dなどの積層化された先端半導体パッケージの必要性が高まっています。
3D実装を実用化するための技術開発
3D実装する先端半導体パッケージにおいては、半導体チップとプリント基板の間にコア基板※2を配置し、双方を接続する貫通ビア (配線用の穴) を開け、配線します。
この半導体の動作時には、最高約300℃の熱が発生し、従来の樹脂基板では反りや劣化を引き起こす可能性があります。この課題に対応するため、コア基板に耐熱性の高いガラスを用いる開発が進められています。
ガラス基板を活用するための課題
ガラス基板の貫通ビアに配線を形成するTGVを実用化する方法として、銅でのめっき技術が有力視されていますが、作業時間が長いことや、ビアにクラック (亀裂) が発生しやすいことが課題です。
開発品の特長

開発品は、銅めっき技術の課題を解決するTGV用銀ペーストです。独自の組成設計と粒子分散技術により、銀の粒子の量を最大限に増やすことで、従来の銅めっき技術と同等の抵抗値のまま、配線工程の効率を大幅に向上させました。
①作業時間を5分の1に短縮
銀ペーストを貫通ビアに充填し、焼結させることで配線を形成するため、作業時間が大幅に短縮。めっき前の下処理工程も不要。
②不良低減に貢献
半導体の動作時の温度変化に耐えうる組成と粒子分散技術により、クラックの発生を抑制※3。
開発品を用いた配線により、耐熱性に優れたガラス基板の普及を促進し、先端半導体パッケージの高速処理化や消費電力の低減を実現することで、AIのさらなる普及・拡大に貢献します。
開発品の使用箇所
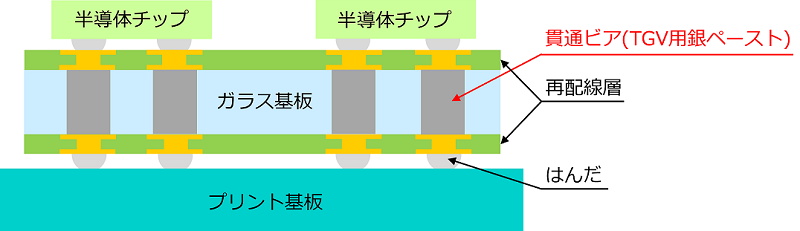
※1 ガラス基板において異なる層を電気的に接続するために垂直に穴を開け配線を形成すること。
※2 半導体チップとプリント基板を接続し、電気的信号の伝達や電力の供給を行うとともに、パッケージの強度を高める基板。
※3 -65℃ (30分間) と125℃ (30分間) の冷熱衝撃試験のサイクルを100回繰り返した結果、クラックの発生が確認されなかった。
本件に関するお問い合わせ先
ノリタケ株式会社 広報室
TEL:052-561-7110 FAX:052-561-9721









